@2x%20(1).jpg)
10000V!国产GaN创全球最高纪录!
 2021-06-22
2021-06-22
近日,苏州晶湛半导体有限公司宣布,其与美国弗吉尼亚理工大学电力电子技术中心(CPES)合作制备的肖特基势垒二极管(SBD),成功实现了超过10kV的超高击穿电压。这是迄今为止GaN功率器件击穿电压的最高记录。值得一提的是,该器件的GaN外延结构基于蓝宝石衬底,因此制备成本比SiC便宜2-3倍。相关研究成果已于2021年6月发表于IEEE Electron Device Letters期刊。
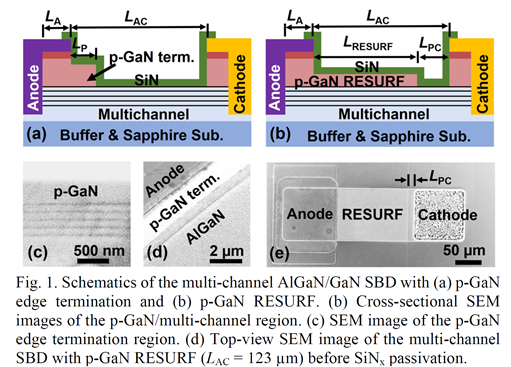
多沟道AlGaN/GaN SBD器件结构图
(引用自IEEE ELECTRON DEVICE LETTERS, VOL. 42, NO. 6, JUNE 2021)
这项技术突破采用了苏州晶湛新型多沟道AlGaN/GaN异质结构外延片,并运用了pGaN降低表面场技术(RESURF)。
其中,苏州晶湛的GaN外延材料结构包括:20nm p+GaN/350nm p-GaN帽层,以及23nm Al0.25Ga0.75N/100nmGaN本征层的5个沟道。
该外延结构由苏州晶湛通过MOCVD方法在4英寸蓝宝石衬底上单次连续外延实现,无需二次外延。基于此外延结构开发的GaN器件结构如上图所示,在刻蚀工艺中,通过仅保留2微米的p-GaN场板结构(或称为降低表面场(RESURF)结构),能够显著降低峰值电场。在此基础上制备的多沟道GaN SBD,在实现10kV的超高击穿电压的同时,巴利加优值高达2.8GW⁄cm^2 , 导通电阻率低至39mΩ∙cm^2,远低于同样10kV耐压的 SiC 结型SBD。
由于采用廉价的蓝宝石衬底和水平器件结构,多沟道GaN器件的制备成本也远低于SiC二极管。
据了解,与4英寸SiC相比,4英寸蓝宝石基GaN晶圆的成本降低了2-3倍左右。并且苏州晶湛器件的芯片尺寸更小,因此该器件的材料成本远低于同级SiC SBD,而且横向GaN器件的加工成本也比SiC低。
此外,经过估算,10kV、0.3A RESURF器件的开关品质因数为15.7nCV,而3.3kV、0.3A SIC SBD为30.8nCV。
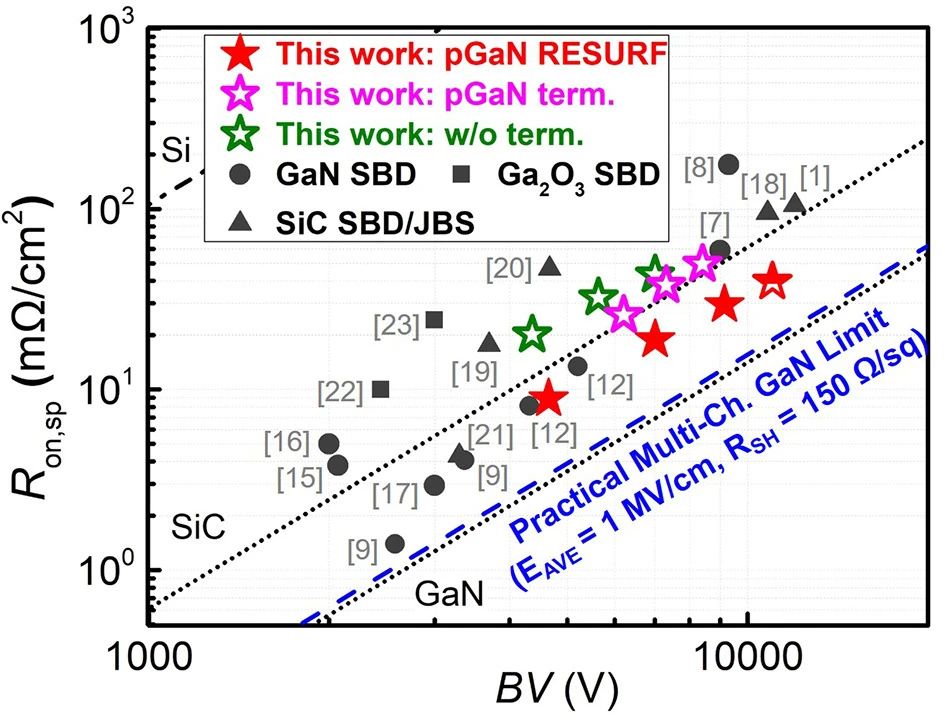
晶湛SBD与其他GaN、SiC、氧化镓SBD的
导通电阻和BV基准的对比情况(虚线为理论极限)
创新性的多沟道设计可以突破单沟道GaN器件的理论极限,进一步降低开态电阻和系统损耗,并能实现超高击穿电压,大大拓展GaN器件在高压电力电子应用中的前景。在“碳达峰+碳中和”的历史性能源变革背景下,氮化镓电力电子器件在电动汽车、充电桩、可再生能源发电、工业电机驱动器、电网和轨道交通等高压应用领域具有广阔潜力。
苏州晶湛已于近日发布了面向中高压电力电子和射频应用的硅基、碳化硅基以及蓝宝石基的新型多沟道AlGaN/GaN异质结构外延片全系列产品,持续致力于推动氮化镓电力电子技术和应用的新发展。




.png)

.png)